NAND 快閃記憶體:產業中的主要儲存技術
自 1980 年代後期進入記憶體市場以來,NAND 快閃記憶體徹底改變了我們儲存與讀取大量資料的方式。這項廣受歡迎的記憶體技術在架構上經過最佳化,適合高密度資料儲存,並廣泛應用於所有主要電子終端產品市場,包括智慧型手機、資料伺服器與個人電腦。你也能在大多數可拆卸式與攜帶式記憶裝置中找到它,例如 SD 卡與 USB 隨身碟。NAND 屬於非揮發性記憶體,可讓照片、影片、音訊檔案、封存郵件及其他文件得以儲存並可在長達十年間被讀取。最近,NAND 快閃記憶體在 AI 與機器學習中也扮演了重要角色,例如為訓練 AI 模型所需的海量資料提供高效率的儲存空間。NAND 快閃記憶體之所以成功,源自於其持續提升記憶體單元密度與降低成本的能力。多年來,NAND 產業大幅提升位元儲存密度(通常以 Gbit/mm² 表示)。為了維持這個進步趨勢,業界已導入多項創新技術,包括:從 2D NAND 過渡到 3D NAND、提高每個記憶單元可儲存的位元數(商用 NAND 已可達四位元),以及從浮動閘極電晶體轉向採用電荷捕捉式記憶單元等,這些都是最重要的技術演進。
3D 全環繞閘極(GAA)記憶單元架構:NAND 快閃記憶體產業的主力技術
具備全包覆閘極(GAA)垂直架構的 3D NAND 快閃記憶體,是當今高密度資料儲存應用的主力技術。在此 3D 架構中,記憶體單元以垂直方式堆疊,形成一條垂直字串,而單元則透過水平字線(word-line)進行選址與操作。在大多數的 3D NAND 產品中,採用電荷捕捉(charge trap)記憶單元作為資料儲存元件。此記憶單元類似 MOSFET 電晶體,但在閘氧化層中加入一層薄的氮化矽(SiN),使得閘氧化層形成氧化物–氮化矽–氧化物(ONO)堆疊,分別作為阻擋氧化層、捕捉層與穿隧氧化層。SiN 層中含有大量可捕捉電荷的位置,可以用來儲存電子。當閘極施加正電壓時,通道區的電子會穿隧經過氧化層並被捕捉於 SiN 層中,使得電晶體的臨界電壓升高。要讀取記憶狀態時,則於 source/drain 兩端施加電壓進行測量:若偵測到電流流過,代表沒有電子被捕捉,此單元為「1」狀態;若偵測不到電流,則表示有電子被捕捉於記憶層中,屬於「0」狀態。

在 3D NAND 結構中,電荷捕捉記憶單元是透過垂直通道的 GAA 方式來實現的。可以把它想像成將平面電晶體結構旋轉 90 度,使原本的多晶矽導電通道變成垂直方向,並由閘極堆疊層所包覆。GAA 的製程首先從成長一組矽氧化層/字線層(Si-oxide/word-line stack)開始。接著,利用先進的乾式蝕刻設備,在整個堆疊中垂直鑽孔形成圓柱狀孔洞。之後,在孔洞側壁上沉積氧化層、電荷捕捉層以及多晶矽通道。這種結構常被稱為 「通心麵(macaroni)通道」。
以更多氧化層/字線層延續 NAND flash 技術路線圖
未來幾年,記憶體產業將持續把基於 GAA 的 NAND flash 推向極限。目前主要廠商已能在產品中實現 超過 300 層的氧化層/字線堆疊。這個數字仍會持續提高,預計到 2030 年可達到約 1,000 層,相當於 100 Gbit/mm² 的儲存密度。然而,要在 約 30 µm 厚的堆疊結構中維持字串直徑一致,意味著加工的複雜度與成本不斷上升,尤其是在高縱橫比蝕刻與高厚度堆疊沉積等工藝上。因此,需要引入額外的「縮放增強技術(scaling boosters)」來持續推進技術節點,包括:
- 增加單元可儲存的位元數(如 TLC、QLC,甚至 PLC)。
- 減小 GAA 單元的 x-y 節距(平面方向縮放)。
- 提升記憶體陣列的面積效率。
- 模組堆疊技術(stacking modules)。
另一個趨勢是 將周邊 CMOS 電路移至另一片晶圓上製作,再透過混合鍵合(hybrid bonding)技術與記憶體堆疊整合。為了控制不斷攀升的製程成本,也同時推動另一項關鍵縮放技術:在垂直方向縮小字線間距,即 z 向節距縮放(z-pitch scaling)。
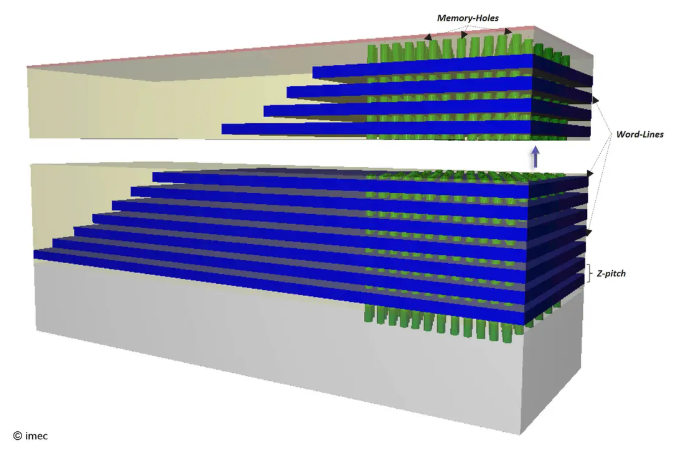
z 向節距縮小(Z-pitch scaling):優點與挑戰
對於下一代多層堆疊、基於 GAA 的 3D NAND flash,z-pitch 縮放對維持成本下降至關重要。藉由縮小相鄰字線之間的節距(目前約 40nm),也就是同時減薄字線層與矽氧化層的厚度,便能在相同的堆疊高度內加入更多層數(因此也增加記憶單元數量),帶來顯著的成本效益。然而,若沒有額外的最佳化,實驗結果顯示 z-pitch 縮小會 負面影響記憶單元的電性表現,包含:臨界電壓下降、次臨界擺幅(sub-threshold swing)惡化、資料保持能力下降、Program / Erase 操作的所需電壓升高等。
這些效應主要來自兩種隨著縮放而更加突出的物理現象:單元間干擾(cell-to-cell interference)和橫向電荷遷移(lateral charge migration)。當字線層的厚度減少時,電荷捕捉電晶體的閘極長度縮短,閘極對通道的控制能力變弱,使相鄰記憶單元之間的靜電耦合更強,導致單元間干擾。另外,垂直方向尺寸縮小也會促進 電荷在氮化矽(SiN)記憶層中的上、下方向遷移(vertical / lateral charge migration),直接降低資料保持能力。以下段落將介紹可抑制這些效應、促進 z-pitch 缩小的關鍵技術。
在字線之間導入氣隙(airgap)以降低單元間干擾
TCAD 模擬顯示,在相鄰字線之間導入 氣隙(airgap) 是抑制單元間干擾的有效方法。氣隙的介電常數遠低於 Si-oxide,可顯著降低相鄰記憶單元的靜電耦合。此技術在早期的 2D NAND 產品中已非常成功。然而,要在高層堆疊的 Si-oxide/字線結構中形成氣隙則複雜許多。雖然已有一些方法被提出,但尚未證明具備足夠的可擴展性。在 2025 年 IEEE International Memory Workshop (IMW) 中,imec 提出一種可在字線間受控形成氣隙的獨特整合技術。其核心概念為:
- 從 記憶孔(memory hole)內部引入氣隙
- 在沉積 ONO 堆疊之前,先刻蝕後退(recess)字線間的 Si-oxide
- 氣隙能 自對準(self-aligned)於字線
- 因此氣隙位置可精準控制,也具備可擴展性
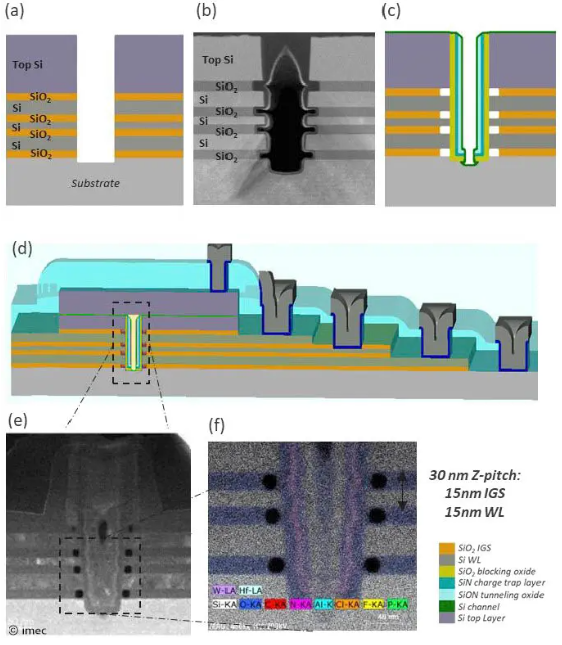
實驗證明,導入氣隙的元件比沒有氣隙的元件 更不易受到鄰近單元干擾。此結論來自以下測試:在未選取字線上施加通過電壓(pass voltage),觀察元件臨界電壓的偏移量,有氣隙的元件顯示出更小的臨界電壓偏移。測試是在以下結構上進行:限定的字線層數,30nm 節距(15nm 閘極長度 + 15nm Si-oxide 間隔),80nm 記憶孔直徑。imec 研究人員同時評估氣隙對記憶體操作與可靠度的影響。結果顯示:氣隙不影響記憶體運作,可達 1,000 次 program/erase endurance,與無氣隙元件相當。基於這些結果,在記憶孔側(hole-side)導入氣隙 被視為實現積極 z-pitch 縮放的關鍵一步。
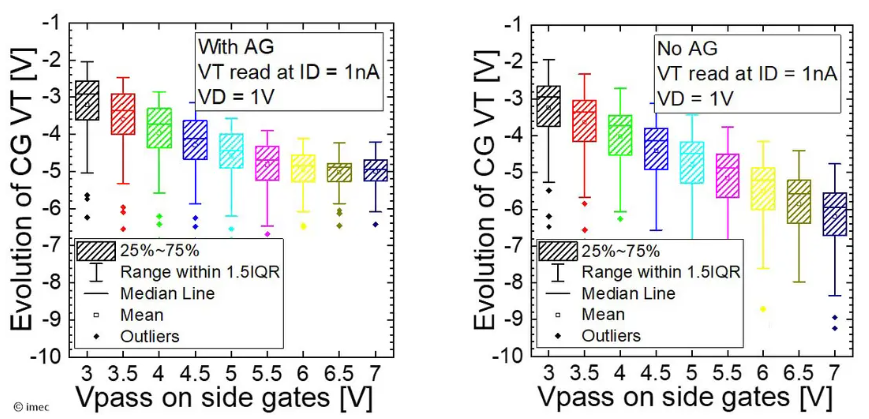
導入電荷捕捉層分離以抑制橫向電荷遷移
迄今為止,imec 已展示在字線間介電層中導入氣隙的可行性,且氣隙「終止」於 ONO 堆疊中的阻擋氧化層位置。TCAD 模擬顯示,若能將氣隙進一步延伸至 阻擋氧化層與 SiN 電荷捕捉層 之中,可進一步改善 記憶體視窗(memory window)。這樣的 電荷捕捉層分離(charge trap layer separation / charge trap cut) 還有另一項重要優勢:可防止儲存在記憶單元內的電荷,沿著整個氧化層/字線堆疊高度方向、透過垂直 SiN 串(SiN string)橫向遷移(vertical/lateral migration),進而大幅改善資料保持能力(retention)。然而,要實現此 charge trap cut 面臨極大挑戰需在 極深且狹窄的記憶孔側壁 進行高度方向性(directional)的蝕刻與沉積,現有用於平面(2D)NAND 的製程技術組合已不再適用。目前 imec 正與其設備供應鏈合作,開發新技術,以便能可控地實現此電荷捕捉層切割。一旦成功導入 charge trap cut,imec 研究人員計畫將其與氣隙整合方案結合,提供完整且可延伸的 z-pitch 縮放技術解決方案。
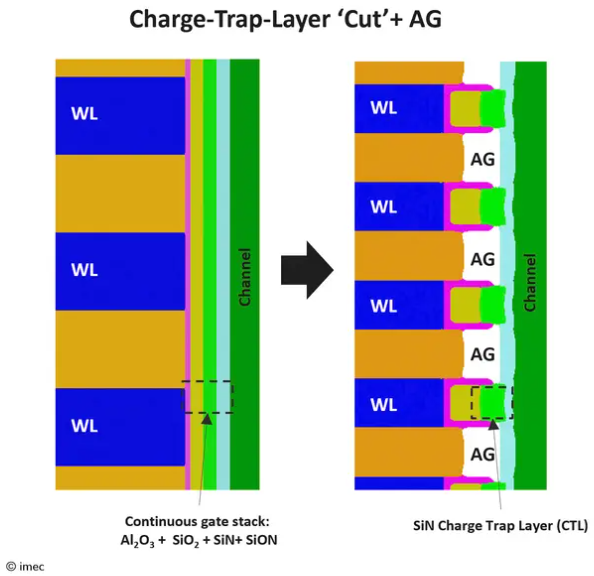
結論與展望
對於基於 GAA 的 3D NAND flash,z-pitch 縮放對控制因字線層數持續增加所帶來的製程成本至關重要。憑藉多年製程專業與強大的設備供應鏈,imec 正在開發兩項關鍵技術,以在維持記憶體操作與可靠度的前提下實現積極的 z-pitch 縮放:氣隙整合(airgap integration)和電荷捕捉層切割(charge trap cut)。然而,採用 GAA 電荷捕捉架構的 3D NAND 其密度提升終將趨於飽和。因此,全球研究團隊也正探索 2030 年後的顛覆性(disruptive)新型記憶體單元架構。例如有研究提出新的 3D 架構,使記憶單元的導電通道由垂直改為水平排列。imec 在 2023 IMW中提出另一種方法:以 槽型(trench-based)架構 連接電荷捕捉記憶單元,而非採用圓柱形 GAA 結構,可大幅提升位元儲存密度。這些技術趨勢顯示,業界已有多項解決方案在研發管線中,將逐步推動記憶體產業邁向 >100 Gbit/mm² 的資料儲存密度 —— 主要需求來自雲端運算與人工智慧(AI)應用。