
元析科技受邀參加 IEEE CSTIC 會議並發表主題演講
元析科技受邀參加 SEMICON China 舉辦的 IEEE CSTIC 會議,發表 "Advanced Interconnects: Better than Cu" 主題演講。
探索最新的材料分析技術、失效案例研究以及半導體產業趨勢。

元析科技受邀參加 SEMICON China 舉辦的 IEEE CSTIC 會議,發表 "Advanced Interconnects: Better than Cu" 主題演講。

麥肯錫分析指出半導體市場2024年實際規模達7,750億美元,遠超傳統估計,預計2030年將攀升至1.6兆美元。

康乃爾大學研究團隊利用電子疊層繞射成像術,首次以三維原子解析度直接觀測到電晶體閘極介電界面的「鼠咬」粗糙缺陷。
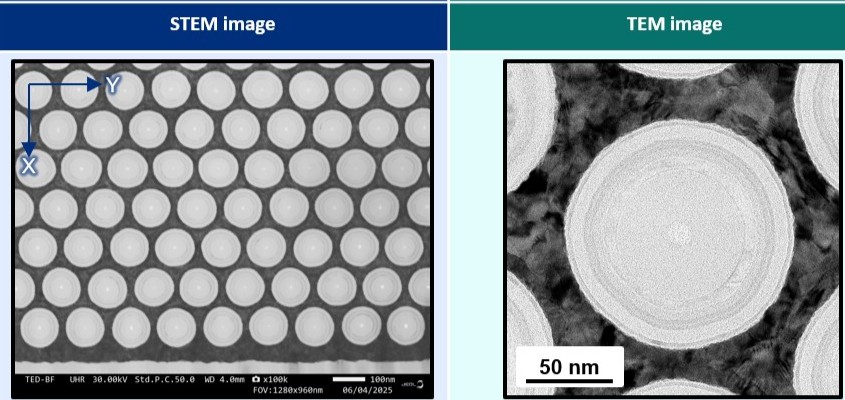
JEOL 展示如何運用 JIB-PS500i FIB-SEM 系統,對 3D NAND 快閃記憶體進行高精度 TEM 試片製備。其可傾斜超過 90° 的載台,允許在不取出試片的情況下直接進行 STEM 驗證,從三個截面方向完成分析,大幅提升奈米級半導體元件的品質檢測效率。
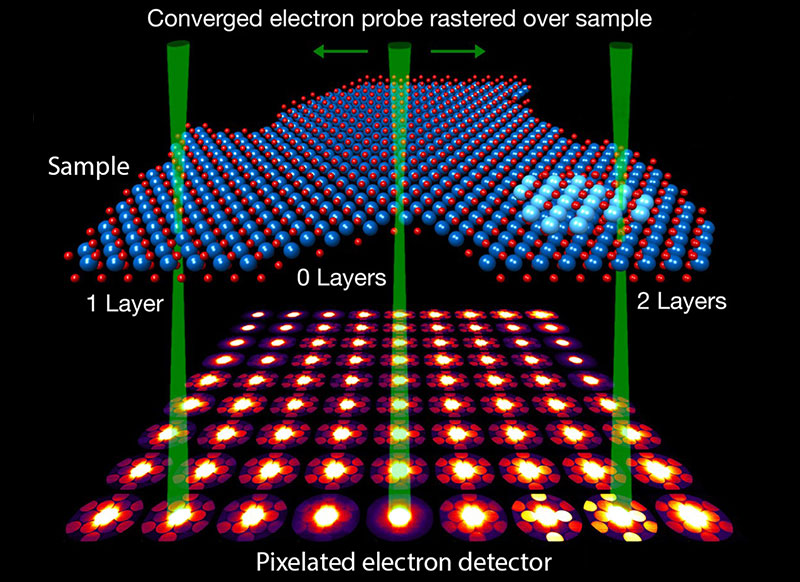
透過整合先進的子取樣演算法與即時影像重建,SenseAI 使 4D-STEM 研究人員能更快速且更有效率地捕捉高品質數據,同時維護即使是最脆弱樣本的完整性。
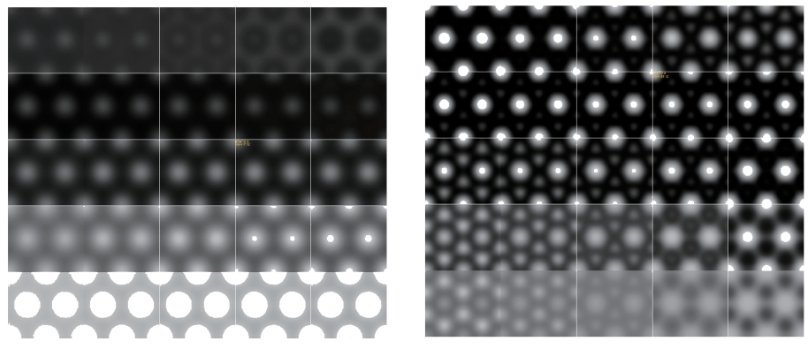
介紹球差校正透射電鏡的原理、優勢、應用及發展,來回答“什麼是球差校正透射電鏡”,“球差校正透射電鏡有什麼突出作用”,“球差校正透射電鏡除了拍原子還能做什麼”這三個問題。
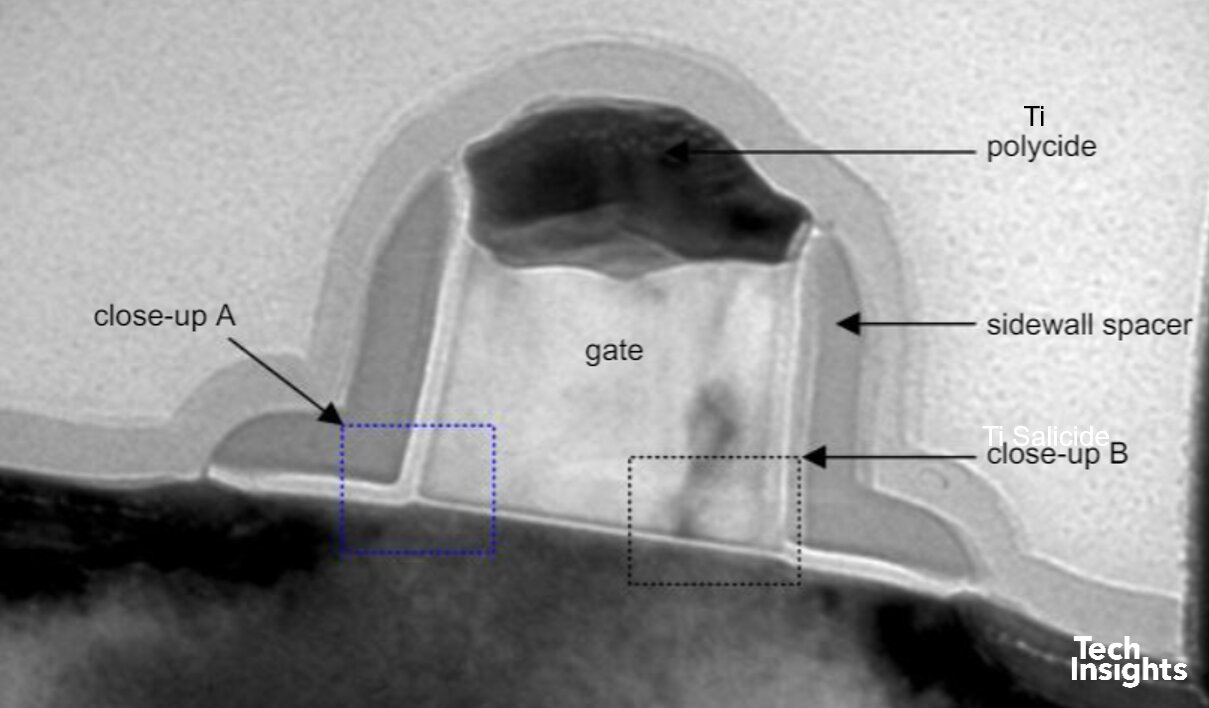
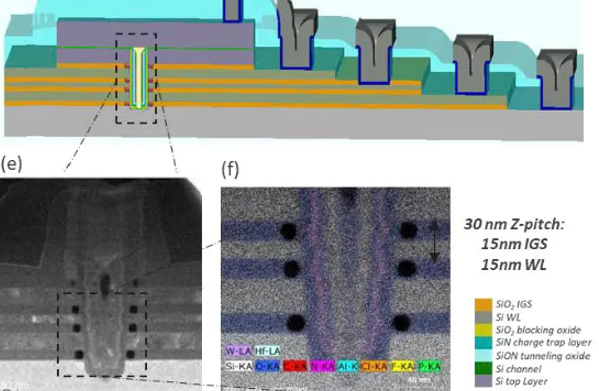
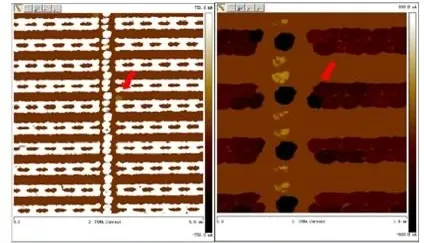
結合具體案例,具體闡述這些理論如何在實際工作中指導我們,從最初的失效信號出發,逐步定位、分析,最終找到問題根源並推動解決方案的形成。

1955年10月11日,宾夕法尼亚州立大学的物理学教授Erwin W. Müller和他的博士生Kanwar Bahadur创造了历史——成功實現單原子成像。