前言
聚焦離子束掃描電子顯微鏡(FIB-SEM)是一種整合了鎵離子束精密加工與掃描電子顯微鏡觀察分析功能的複合系統。其核心優勢在於能夠在加工過程中同步監測截面影像,從而實現對特定位置的精準試片製備。
3D NAND 快閃記憶體已廣泛應用於智慧型手機與個人電腦等消費性電子產品中。其結構由數十至數百奈米的精細單元規律堆疊而成,對分析儀器的空間解析度與定位精度提出了極高要求。本研究採用 JEOL JIB-PS500i FIB-SEM 系統,結合其高解析度 SEM 功能與優化的 STEM 工作流程支援,對 3D NAND 結構進行了系統性的試片製備與品質評估。
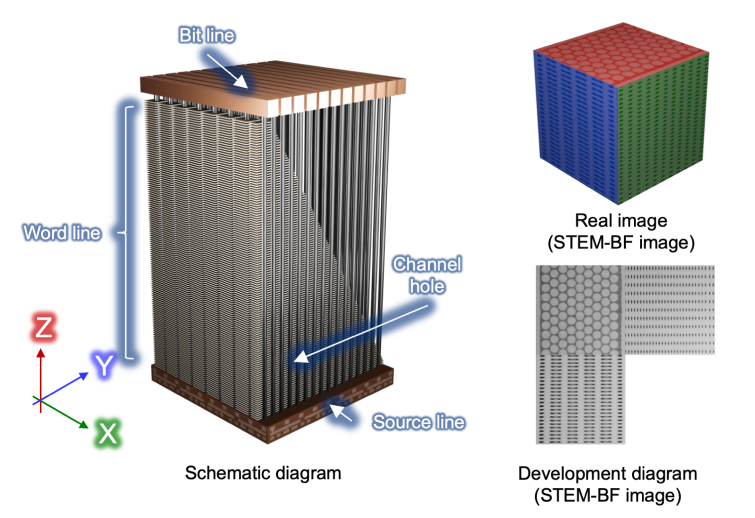
FIB 試片製備流程
傳統 TEM 試片製備方法的基本步驟為:首先從基材上切取目標區塊,再將其固定於 FIB 樣品台上,最後進行離子束薄化至電子束可穿透的厚度(通常為數十奈米以下)。
JIB-PS500i 的關鍵硬體優勢在於其樣品台可傾斜角度超過 90°。此設計使操作者無需將試片從腔體中取出,即可直接在系統內進行 STEM 確認觀察。這不僅大幅縮短了製備週期,也有效降低了試片在轉移過程中受到汙染或損壞的風險,對於高精度的奈米結構分析尤為重要。

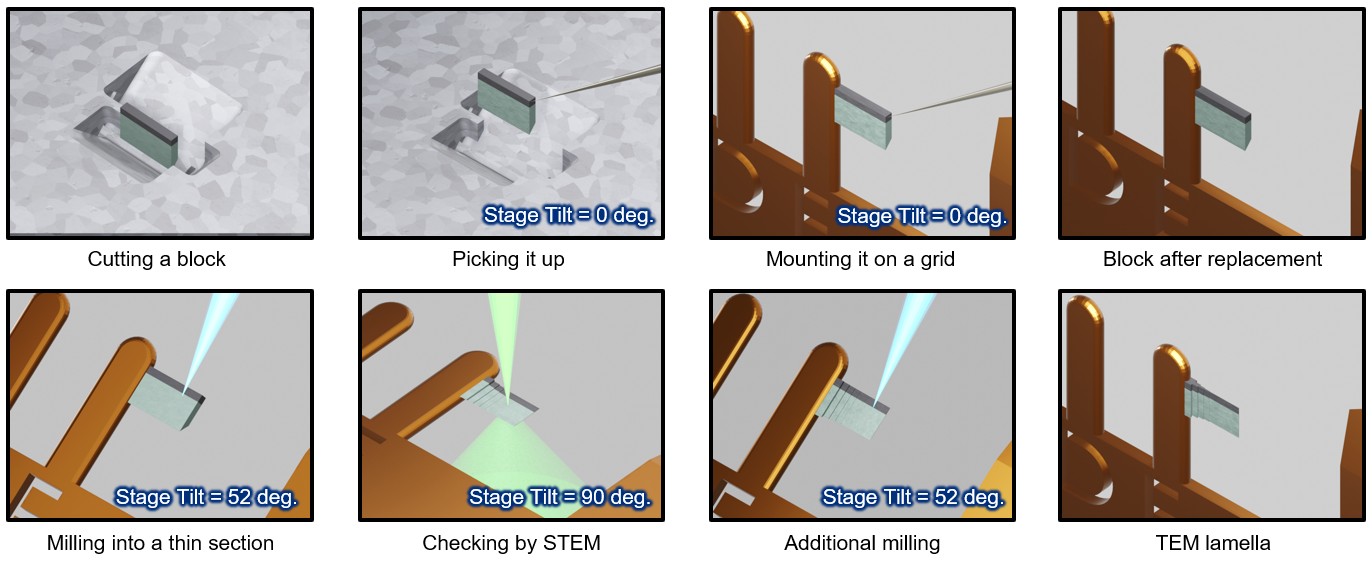
實驗結果
本研究從三個正交方向對 3D NAND 結構進行了截面分析,分別為:
- YZ 截面:觀察堆疊層間的縱向結構與層間界面特徵。
- XZ 截面:分析元件在深度方向的均勻性與製程一致性。
- XY 截面:評估頂視方向的圖案佈局與結構完整性。
針對每個截面方向,研究團隊分別取得了 JIB-PS500i 的 SEM 影像、系統內 STEM 影像,以及後續使用 JEM-ARM200F 球差校正分析電子顯微鏡所拍攝的高解析 TEM-STEM 影像。三種影像相互對應,有效驗證了試片製備品質。
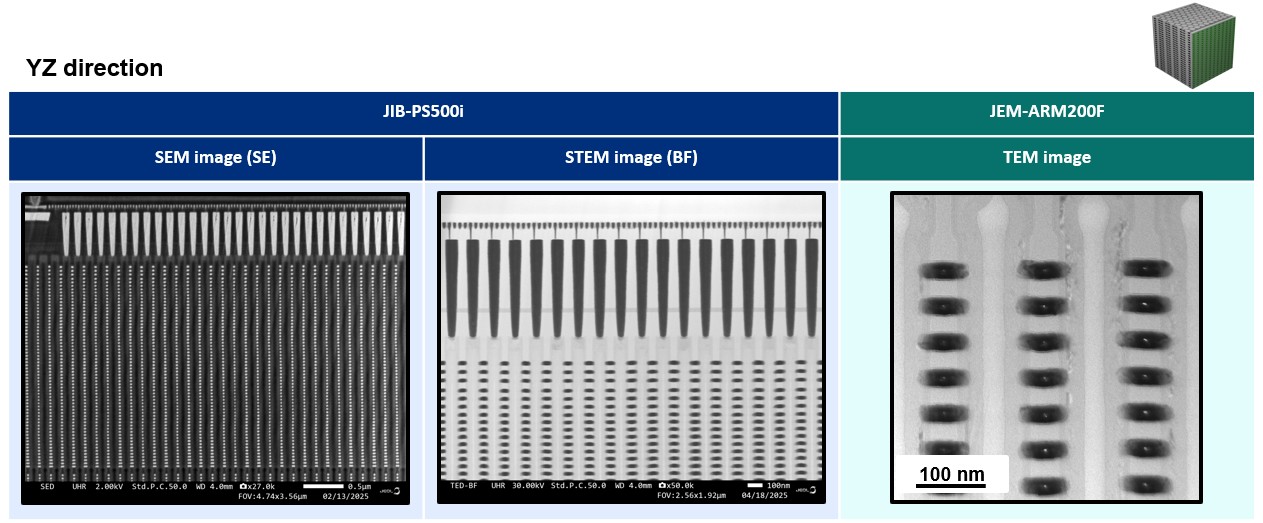
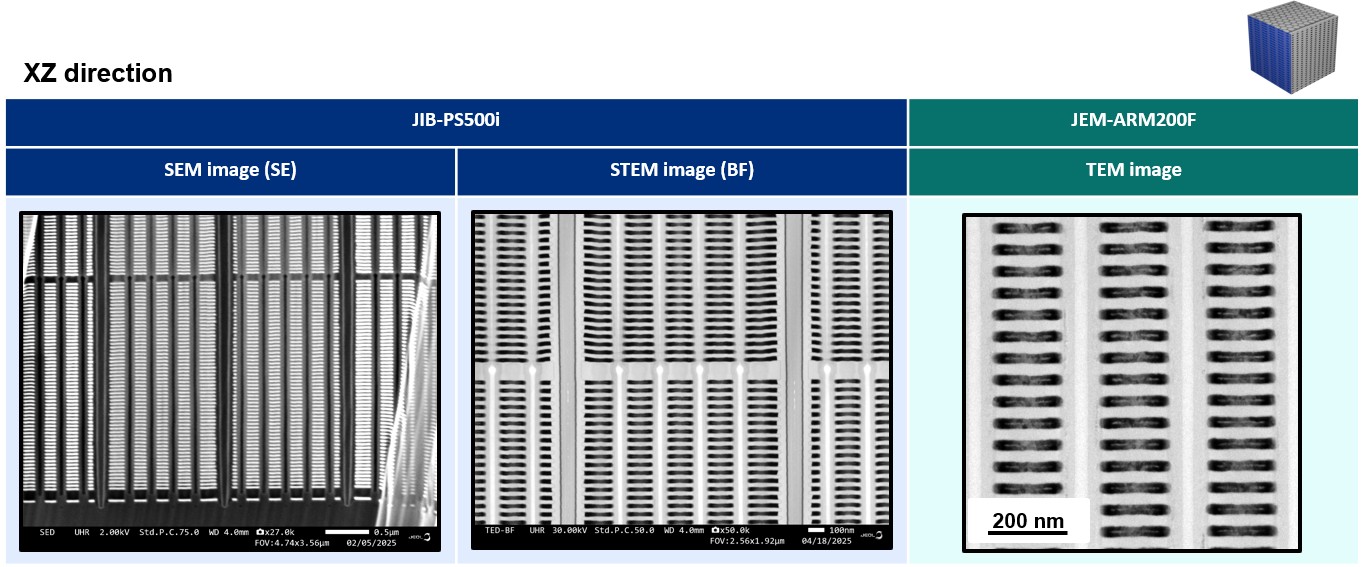
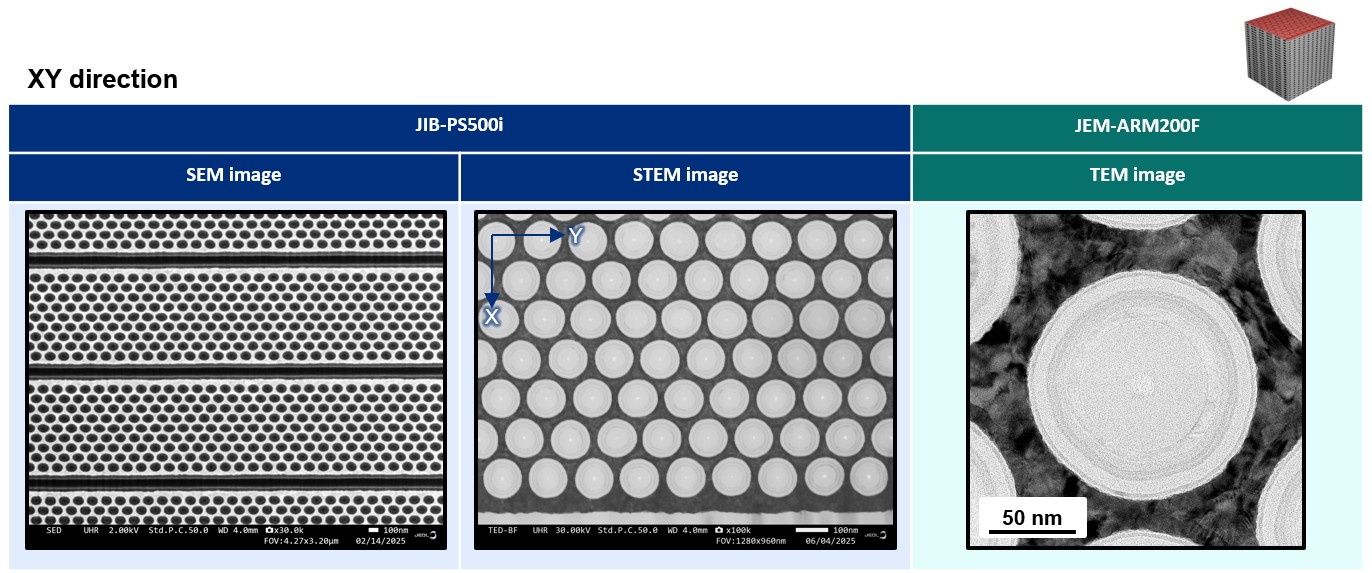
結論
本研究驗證了 JIB-PS500i FIB-SEM 系統在 3D NAND 多方向 TEM 試片製備上的高可靠性。其超過 90° 的載台傾斜能力,使 STEM 原位確認成為可能,簡化了作業流程並提升了試片品質的一致性。最終所獲得的 TEM-STEM 影像解析度足以清晰呈現奈米級半導體精細結構,充分滿足 3D NAND 品質檢測與製程開發的分析需求。
隨著 3D NAND 持續朝更高堆疊層數與更小特徵尺寸發展,FIB-SEM 結合球差校正 TEM 的聯合分析方案,將在半導體製程監控與失效分析領域扮演愈加關鍵的角色。